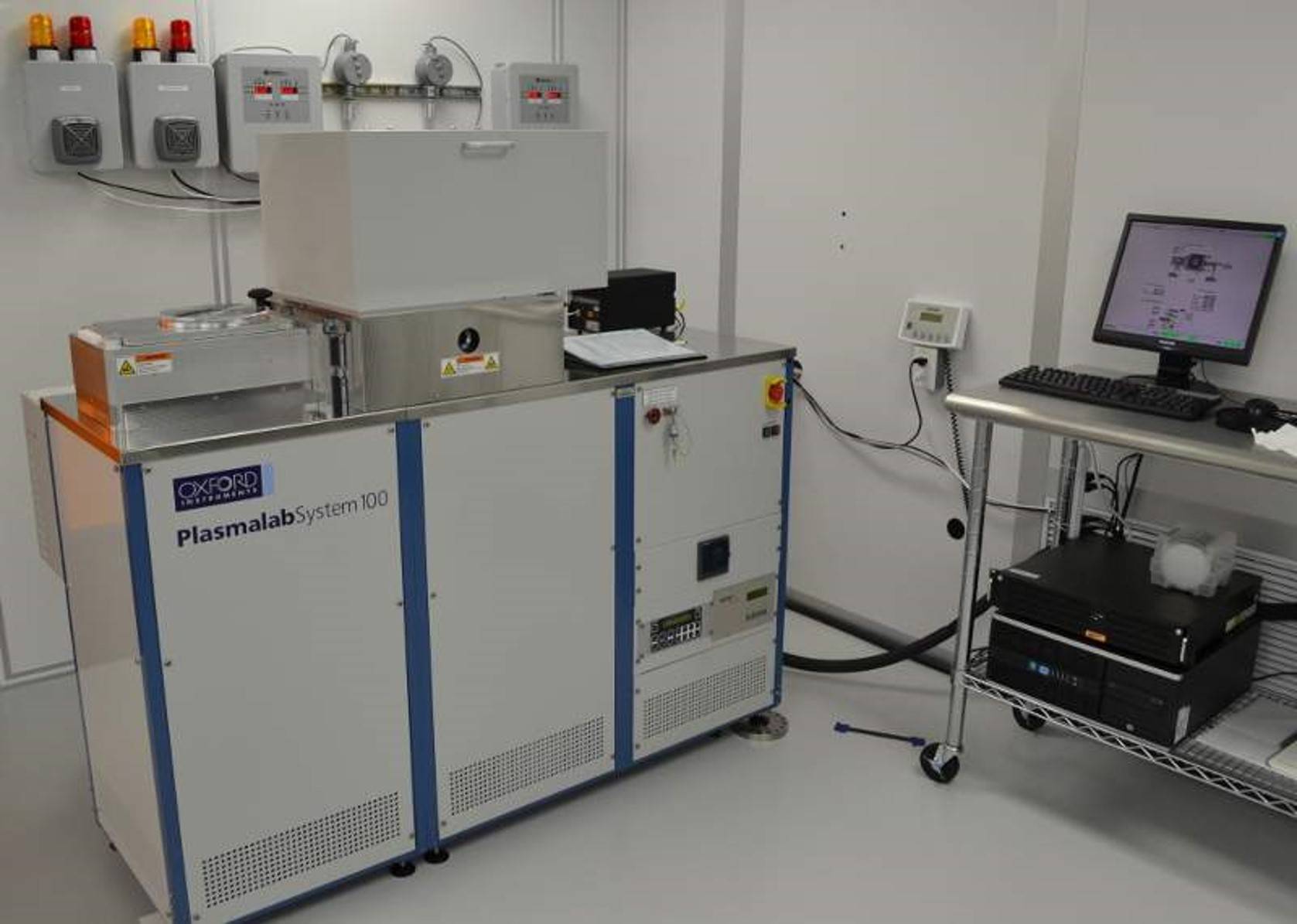
Description
Our Oxford ICP-RIE Plaslab 180 utilizes a 3kW RF power supply to generate a remote plasma of Cl2, BCl3, H2, Ar, NF3, O2, SF6, and/or C4F8 gas species that can be further accelerated (300W table bias) toward a substrate resulting in a combination of physical and chemical dry etching for material removal. The turbomolecular pumped system achieves a base pressure < 1E-7 Torr and is equipped with chuck temperature control from -110 to 350 degrees C.
Capabilities
- Max substrate 200mm (etch area is 100mm defined by quartz clamp)
- Physical etch assist via Ar
- Chemical etch via F or Cl species
- Modification of etching environment toward reducing (H2) or oxidizing (O2)
- Cryo-cooled stage for deep RIE etching (e.g. Bosch)
Location: RFM 1246
Manager: Melvin Cruz, melvincruz@txstate.edu
Backup: Dr. Casey Smith, casey.smith@txstate.edu, 512-213-7909
Model: Oxford Plasmalab 180